矽穿孔TSV封裝檢視原始碼
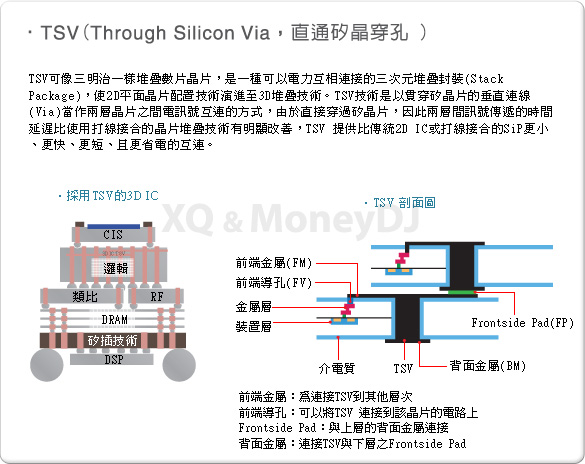 |
TSV是一種矽通孔封裝技術。 這是一種互連科技,能夠使3D封裝遵循摩爾定律。 其設計概念來自多層印刷電路板(PCB)的設計。 TSV可以像三明治一樣堆疊幾塊薯條。 它是一個可以電力連接的三維堆棧包。 TSV使2D平面晶片配寘科技發展為3D堆棧科技,並已開始在生產線上運行。[1]
TSV 立體堆疊技術,包含晶圓的薄化、鑽孔、以導電材質填孔、晶圓連接等,將所有晶片結合為一。TSV 的晶片堆疊並非打線接合(Wire Bonding)的方式,而是在晶片鑽出小洞,從底部填充入金屬,作法是在每一個矽晶圓上以蝕刻或雷射方式鑽孔(via),使其能通過每一層晶片,再以導電材料如銅、多晶矽、鎢等物質填滿,而形成一通道道(即內部接合線路)來做連接的功能,最後則將晶圓或晶粒薄化再加以堆疊、結合(Bonding),作為晶片間傳輸電訊號用之堆疊技術。
TSV科技使得連接線也可以位於晶片的中間,不局限於晶片的週邊,使得內部連接路徑更短,相對來說使得晶片之間的傳輸速度更快,雜訊更少,效能更好。 同時,它可以實現高密度配寘,可以應用於類比和數位、矽基和35系列、記憶體和RF等異構晶片堆疊。[2]
TSV的立體互連科技具有互連路徑更短、電阻和電感更低、訊號和功率傳輸更高效、裸晶體堆棧數量無限制等優點。 CMOS感測器和記憶體已經採用TSV科技,未來基頻、射頻、處理器等的應用趨勢日益明顯。
TSV過程包括先經和後經。 後者的挑戰相對較小。 它應該首先應用於市場。 它的結構很大,很容易製作。 它與SiP(封裝中的系統)或市場上的其他應用程序具有高度的連通性。 囙此,它是包裝行業一個熱門的研發領域。
在第一個鑽孔過程中,通道是在任何電晶體工藝之前完成的,囙此存在更多的科技挑戰和工藝結構的更多方面,例如通道形成的科技困難,無論是從蝕刻鑽孔、添加合適的絕緣體、以及植入和電鍍金屬材料。 但首次鑽井具有高傳輸率(I/O),這使得許多運營商對首次鑽井抱有很高的期望。
影片
【財經知識庫】半導體下一個關鍵技術 3D IC市場成長中 (上)
參考資料
- 移至 ↑ 矽穿孔TSV封裝04.2017 MoneyDJ理財網
- 移至 ↑ Integrated Circuit Test Engineering: Modern Techniques.01.30.2013 Ian Grout